How can we help you? Get in touch with us
TEM試片製備
在FIB橫截面的TEM樣品製備上,有三種作法:預先薄化法 (Pre-Thin)、靜電吸取法 (Lift-out)、探針取出法 (Omni-probe)。至於FIB的選擇,則取決於樣品的分析需求。
 |
|
1. 預先薄化法 (Pre-Thin) |
顯示預先薄化法的試片製備,先以研磨方式將試片減薄到 5-10 μm 後,再用 FIB 減薄到可供 TEM 觀察的 0.1 μm 厚度。這個方法的優點是可得到非常大面積 (~50 μm),且厚度均勻的 TEM 試片,由於薄區四周仍由相同材質的材料固定住,因此薄區試片不會有變形或捲曲之慮,但是這個方法必須經研磨,再經 FIB 切割,因此比較費工、耗時,仍有研磨失敗的風險。
 |

|
|
2. 靜電吸取法 (Lift-out) |
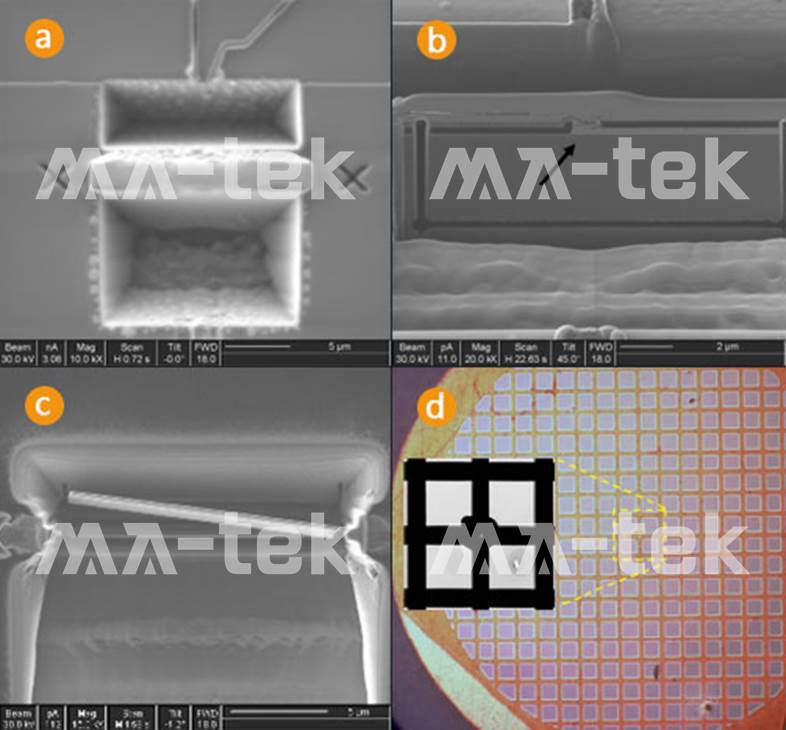 |
|
|
3. 探針取出法 (Omni-probe) |
顯示探針取出法,將試片以 FIB 粗切至 1-2 μm 左右脫離樣品後,以 FIB 沉積 Pt 將探針與試片焊在一起,再移動探針將試片移至試片座,以 FIB 沉積 Pt 將試片焊在試片座上後,以 FIB 將探針切離試片,最後再以 FIB 將試片細修至可供 TEM 觀察的薄度。
這是最複雜、最耗時的 TEM 試片製備法,全部工時大約 1.5-2 小時之間,但是這個方法可以在 TEM 觀察後若有任何需要局部修整的試片厚度,可以一再的重覆進出 FIB 再施工,因此可以保證 TEM 試片製備的零失誤與零風險,通常對於非常重要的試片分析皆採用此法。
 |
|
|
聯絡窗口 |
|||||||||||
|
|
||||||||||
|
|
|||||||||||
|

